随着物联网时期来临,环球终端电子产品逐渐走向多功能整合及低功耗设计,因而使得可将多颗裸晶整合在单一封装中的SIP技能日益受到关注。除了既有的封测大厂积极扩大SIP制造产能外,晶圆代工业者与IC基板厂也竞相投入此一技能,以知足市场需求。
早前,苹果发布了最新的apple watch腕表,里面用到SIP封装芯片,从尺寸和性能上为新腕表增色不少。而芯片发展从一味追求功耗低落及性能提升(摩尔定律),转向更加务实的知足市场的需求(超越摩尔定律)。

本文从五个方面来阐发SIP封装工艺,从而让大家看懂SIP封装的真正用场。
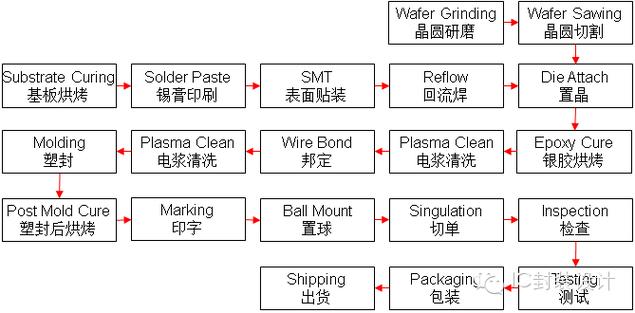
一、SIP产品封装先容
什么是SIP?
SiP模组是一个功能完好的子系统,它将一个或多个IC芯片及被动元件整合在一个封装中。此IC芯片(采取不同的技能:CMOS、BiCMOS、GaAs等)是Wire bonding芯片或Flipchip芯片,贴装在Leadfream、Substrate或LTCC基板上。被动元器件如RLC及滤波器(SAW/BAW/Balun等)以分离式被动元件、整合性被动元件或嵌入式被动元件的办法整合在一个模组中。
什么情形下采取SIP ?
当产品功能越来越多,同时电路板空间布局受限,无法再设计更多元件和电路时,设计者会将此PCB板功能连带各种有源或无源元件集成在一种IC芯片上,以完成对全体产品的设计,即SIP运用。
SIP优点
1、尺寸小
在相同的功能上,SIP模组将多种芯片集成在一起,相对独立封装的IC更能节省PCB的空间。
2、韶光快
SIP模组板身是一个别系或子系统,用在更大的系统中,调试阶段能更快的完成预测及预审。
3、本钱低
SIP模组价格虽比单个零件昂贵,然而PCB空间缩小,低故障率、低测试本钱及简化系统设计,使总体本钱减少。
4、高生产效率
通过SIP里整合分离被动元件,降落不良率,从而提高整体产品的成品率。模组采取高阶的IC封装工艺,减少系统故障率。
5、简化系统设计
SIP将繁芜的电路融入模组中,降落PCB电路设计的繁芜性。SIP模组供应快速改换功能,让系统设计职员轻易加入所需功能。
6、简化系统测试
SIP模组出货前已经由测试,减少整机系统测试韶光。
7、简化物流管理
SIP模组能够减少仓库备料的项目及数量,简化生产的步骤。
SIP工艺流程划分
SIP封装制程按照芯片与基板的连接办法可分为引线键合封装和倒装焊两种。
引线键合封装工艺
倒装焊工艺流程
引线键合封装工艺所需质料和设备
引线封装工艺产品构造
倒装工艺产品构造
SIP导入流程
二、SIP工艺解析
引线键合封装工艺工序先容
圆片减薄
为保持一定的可操持性,Foundry出来的圆厚度一样平常在700um旁边。封测厂必须将其研磨减薄,才适用于切割、组装,一样平常须要研磨到200um旁边,一些叠die构造的memory封装则需研磨到50um以下。
圆片切割
圆片减薄后,可以进行划片,划片前须要将晶元粘贴在蓝膜上,通过sawwing工序,将wafer切成一个 一个 独立的Dice。目前紧张有两种办法:刀片切割和激光切割。
芯片粘结
贴装的办法可以是用软焊料(指Pb-Sn合金,尤其是含Sn的合金)、Au—Si低共熔合金等焊接到基板上,在塑料封装中最常用的方法是利用聚合物粘结剂粘贴到金属框架上。
引线键合
在塑料封装中利用的引线紧张是金线,其直径一样平常0.025mm~0.032mm。引线的长度常在1.5mm~3mm之间,而弧圈的高度可比芯片所在平面高0.75mm。键合技能有热压焊、热超声焊等。
等离子洗濯
洗濯的主要浸染之一是提高膜的附着力。等离子体处理后的基体表面,会留下一层含氯化物的灰色物质,可用溶液去掉。同时洗濯也有利于改进表面黏着性。
液态密封剂灌封
将已贴装好芯片并完成引线键合的框架带置于模具中,将塑封料的预成型块在预热炉中加热,并进行注塑。
装置焊料球
目前业内采取的植球方法有两种:“锡膏”+“锡球”和“助焊膏”+“锡球”。
(1)“锡膏”+“锡球”
详细做法便是先把锡膏印刷到BGA的焊盘上,再用植球机或丝网印刷在上面加上一定大小的锡球。
(2)“助焊膏”+“锡球”
“助焊膏”+“锡球”是用助焊膏来代替锡膏的角色。
表面打标
打标便是在封装模块的顶表面印上去不掉的、字迹清楚的字母和标识,包括制造商的信息、国家、器件代码等,紧张先容激光印码。
分离
为了提高生产效率和节约材料,大多数SIP的组装事情都因此阵列组合的办法进行,在完成模塑与测试工序往后进行划分,分割成为单个的器件。划分分割紧张采取冲压工艺。
测试
它利用测试设备(Testing Equipment)以及自动分选器(Handler),测定封装IC的电气特性,把良品、不良品区分开来;对某些产品,还要根据测试结果进行良品的分级。
测试按功能可分为DC测试(直流特性)、AC测试(互换特性或timing特性)及FT测试(逻辑功能测试)三大类。同时还有一些赞助工序,如BT老化、插入、拔出、实装测试、电容充放电测试等。
包装
紧张目的是担保运输过程中的产品安全,及长期存放时的产品可靠性。
对包装材料的强度、重量、温湿度特性、抗静电性能都有一定的哀求。紧张材料有Tray盘,抗静电袋,干燥剂、湿度卡,纸箱等。包装完毕后,直接入库或按照哀求装箱后直接发货给客户。
倒装焊封装工艺工序先容
焊盘再分布
为了增加引线间距并知足倒装焊工艺的哀求,须要对芯片的引线进行再分布。
制作凸点
焊盘再分布完成之后,须要在芯片上的焊盘添加凸点,焊料凸点制作技能可采取电镀法、化学镀法、蒸发法、置球法和焊膏印尽4法。目前仍以电镀法最为广泛,其次是焊膏印刷法。
电镀法添加焊料凸点的工艺流程
印刷法添加焊料凸点的工艺流程
倒装键合、下添补
在全体芯片键合表面按栅阵形状支配好焊料凸点后,芯片以倒扣办法安装在封装基板上,通过凸点与基板上的焊盘实现电气连接,取代了WB和TAB在周边支配端子的连接办法。倒装键合完毕后,在芯片与基板间用环氧树脂进行添补,可以减少施加在凸点上的热应力和机器应力,比不进行添补的可靠性提高了l到2个数量级。
其他工序与引线键合工艺工序同等
三、SMT生产工艺寻衅
元件小型化
0201 Chip元件逐步淘汰
随着产品集成化程度越来越高,产品小型化趋势不可避免,因此0201元件在芯片级制造领域受到微型化发展趋势,将被逐步淘汰。
01005 Chip元件遍及
随着苹果i-watch的面世,SIP的空间设计受到寻衅,伴随苹果,三星等移动设备的高标哀求,01005 chip元件开始普遍运用在芯片级制造领域。
公制0201 Chip元件开始推广
SIP工艺的发展,哀求元件板身必须小型化,随着集成的功能越来越多,PCB承载的功能将逐步转移到SIP芯片上,这就哀求SIP在知足功能的条件下,还能降尺寸掌握在合理范围,由此催生出0201元件的推广与运用。
元件密集化
Chip元件密集化
随着SIP元件的推广,SIP封装所需元件数量和种类越来越多,在尺寸受限或不变的条件下,哀求单位面积内元件密集程度必须增加。
贴片精度高精化
SIP板身元件尺寸小,密度高,数量多,传统贴片机配置难以知足其贴片哀求,因此须要精度更高的贴片设备,才能知足其工艺哀求。
工艺哀求越来越趋于极限化
SIP工艺板身便是系统集成化的结晶,但是随着元件小型化和布局的密集化程度越来越高,势必度传统工艺提出寻衅,印刷,贴片,回流面临前所未有的工艺寻衅,因此须要工艺管控界线向着6 Sigma靠近,以提高良率。
异形元件处理
Socket / 层叠型等异形元件
因便携式产品的不断发展,功能集成越来越多,势必要求在原SIP工艺根本上,增加更多功能模块,传统的电容电阻已无法知足多功能集成化哀求,因此须要引入异形元件进行扩展,因此如何在精密化的集成基板上,进行异形元件的贴装,给工艺带来不小寻衅,这就哀求设备精度高,稳定性好,处理更智能化方可知足。
本钱
前期投入大,回报周期长,工艺繁芜,人工本钱高,产品良率低,消耗大。须要大型,稳定,利润率较大的项目方能支撑SIP技能的持续运行。
四、SIP发展趋势
多样化,繁芜化,密集化
SIP集成化越来越繁芜,元件种类越来越多
球间距越来越小,开始采取铜柱代替锡球。
多功能化,技能前沿化,低本钱化
新技能,多功能运用最前沿
工艺成熟,成板低落
五、工艺难点
洗濯
定制洗濯设备、洗濯溶液哀求、洗濯参数验证、洗濯标准制订
植球
植球设备选择、植球球径哀求、球体共面性检讨、BGA测试、助焊剂残留哀求
结论:
SIP技能是一项前辈的系统集成和封装技能,与其它封装技能比较较,SIP技能具有一系列独特的技能上风,知足了当今电子产品更轻、更小和更薄的发展需求,在微电子领域具有广阔的运用市场和发展前景。。此外,国际上至今尚没有制订出SIP技能的统一标准,在一定程度妨碍了SIP技能的推广运用。由此可见,未来SIP技能的发展还面临着一系列的问题和寻衅,有待于软件、IC、封装、材料和设备等专业厂家密切互助,共同发展和提升SIP技能。
来源:电子制造技能
‧‧‧‧‧‧‧‧‧‧‧‧‧‧‧‧ END‧‧‧‧‧‧‧‧‧‧‧‧‧‧‧‧争霸工程师界“对王之王”
面包板春联征集大赛
2020年的春节,面包板社区特向网友征集以“电子”为主题的春联作品,精良作品将悬挂在网站首页两侧。
征集韶光2019/12/2 至 2020/1/12征集工具全体电子从业者征集主题作品内容属于“电子行业、电子工程师”即可
赶紧来写下属于自己的春联吧!












