文章目录
[+]
一、模型
BGA的模型紧张有芯片,基板,EMC,焊球,粘结层等组成,在建模的时候,我省略了一部分。

二、因紧张考虑稳态的散热问题,打算量不大,因此可以采取全模型进行剖析。
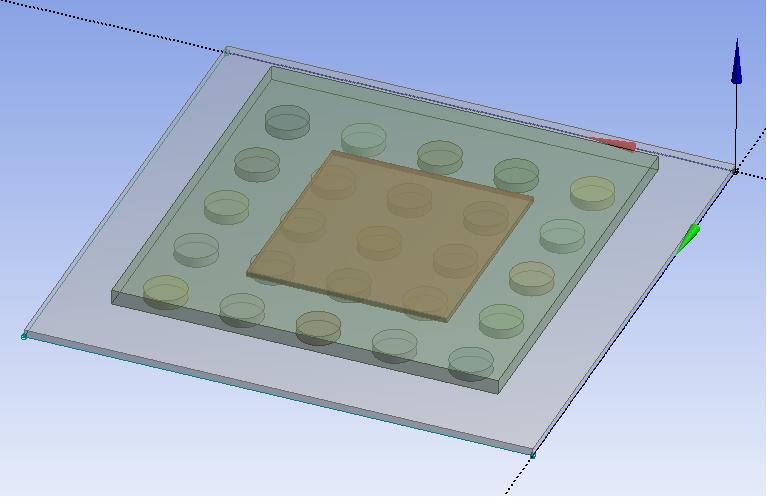
(图片来自网络侵删)
三、对以上各层材料都授予材料参数,热导率可由材料供应商出得到;
四、热源紧张为芯片产生的热,可以根据功率和芯片面积进行换算。本例子中,芯片的热生产率设定为0.075w/mm^2;
五、热对流换热系数设定为2e-4 w/(mm^2K)
六、模型表面还会通过辐射进行散热,可以设定底部或者上部材料的黑度值为0.9;
七、环境温度设置为22C;
八、打算的结果如下:
可以看出,在该事情功率下,芯片的温升仅为31摄氏度。














