如图 1.2 所示,光刻机采取步进扫描技能;当晶圆在晶圆台上移动时,晶圆上的一小块矩形区域(称为die)被曝光。同时,掩模版在掩模版台上沿与晶圆移动方向相反的方向移动。
如图 1.2(b) 所示,每次曝光代表单个芯片的投影(扫描)。完成单个芯片的投影后,晶圆台和(b)跨硅晶圆上芯片的步进扫描曝光轮廓的一部分。

将晶圆移动到下一个芯片位置(步进)。移动掩模版的曝光比固定掩模版的曝光有几个上风,如下所述。
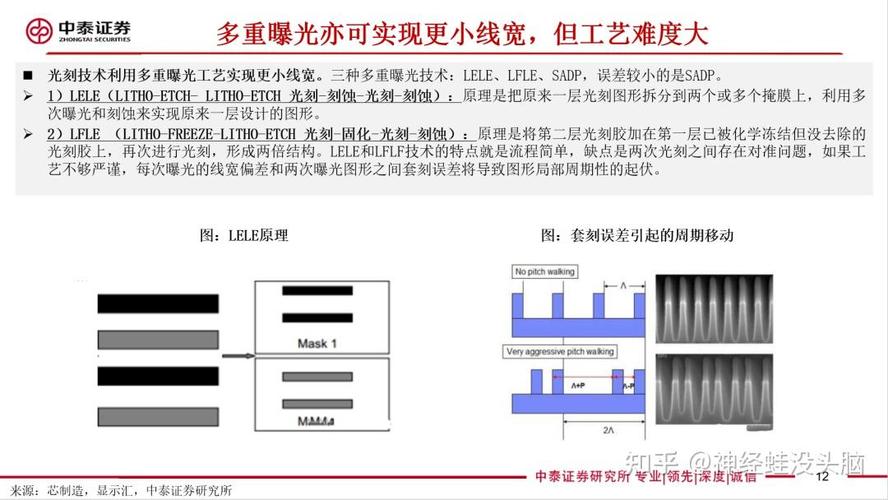
由于掩模版在移动,图案中的每个点都在曝光狭缝的全体宽度上曝光。因此,投影镜头引起的定位偏差由狭缝另一部分的反向偏差补偿。因此,在随机偏差的情形下,这些偏差将会均匀化。
此外,投影镜头盒中的镜头具有圆形横截面。然而,在圆形模具中曝光硅晶片效率低下,由于在这种情形下,大部分晶片都不会曝光。因此,硅晶片上的模具总是矩形的。使掩模版台以扫描办法移动许可利用更大的图案尺寸,而不会增加本钱和镜头尺寸,从而最大化图像场的尺寸。
半导系统编制造机器的精度哀求
有四个紧张指标决定了光刻机的精度哀求。它们是临界尺寸、Overlay、生产率和Fading。下面对这些指标进行理解释。
第一个指标是临界尺寸 (CD)。它被定义为印刷集成电路 (IC) 中可达到的最小特色尺寸。公式 (1.1) 表示光刻机中可达到的 CD 或分辨率。
个中,k1 是工艺参数,范围在 0.25 和 1 之间,λ 是照明光的波长,NA 是透镜的数值孔径,它取决于透镜对光的网络角度,以及透镜和晶圆之间的介质类型。
第二个指标是overlay 套刻精度。它被定义为印刷 IC 中任何连续层之间的水平位置差异。这种类型的毛病会影响 IC 的电气性能,如果超过其极限值(CD 值的 15%),则可能导致短路。
第三个指标是生产率。该指标受一些成分的影响,例如机器可靠性和产量。后者定义为一小时内可以曝光的最大晶圆数量。因此,生产率可以定义为单位韶光内良好曝光的最大次数。虽然生产率对客户更故意义,但产量在机器设计过程中更实用、更高效。
第四个指标是fading。它被定义为“由于曝光过程中机器的振动而导致的比拟度不敷”。这种振动可能是由于光刻机定位台的高速率和加速度而存在的。以上谈论重点先容了光刻工艺的紧张部件和半导系统编制造机器的精度哀求。
知足光刻机的精度哀求
在每个芯片定位的开始阶段,让晶圆和掩模版台稳定下来,直到晶圆和掩模版台之间的对准定位偏差变得足够小,然后再打开照明光。掩模版和晶圆的位置分别通过定位台、掩模版台和晶圆台同时掌握。在扫描过程中,掩模版和晶圆台都必须在 x、y、z、θx、θy 和 θz 方向上跟踪具有寻衅性的参考轨迹。
利用单一类型的实行器无法实现光刻领域的高精度和大行程哀求。因此,半导系统编制造机采取双台构造,个中大范围微米级运动由长行程台利用行程可达 1 米的换向实行器完成。比较之下,小范围纳米级动态跟踪和定位由短行程台利用行程可达 1 毫米的 Lorentz 实行器进行。因此,半导系统编制造机可以以较高的定位精度覆盖较大的范围。光罩和晶圆台之间的同步运动中的任何定位偏差都会导致晶圆上形成的图案在平面内和/或平面外发生偏移,从而降落集成电路的效率。光刻机中有许多引起定位偏差的来源。
光刻机定位不愿定性的来源
1、空气轴承
在超精密定位台中,空气轴承被广泛利用,由于它能够供应具有更少污染、零滞后、零摩擦或磨损的运动平台,以实现纳米级运动。然而,由于气流速率高,空气轴承内会产生空气顶点,从而会在定位台中引起眇小振动。结果,超精密定位台的整体移动和定位精度会降落,并且可能涌现自激不稳定性,从而破坏全体定位台。空气轴承中引起的这些眇小振动会恶化须要纳米级移动和定位精度的制造工艺。
2、带有磁悬浮系统的线圈实行器(马达)
带有音圈实行器的磁悬浮定位台广泛运用于须要微尺度超高精度移动的超精密系统。磁悬浮系统用于补偿平台的重力。然而,这种系统的履行带来了一些问题。
例如,在磁悬浮系统存在的情形下,将多个实行器彼此靠近放置会导致这些实行器与平衡磁铁之间产生电磁串扰;
3、其他定位不愿定性来源还有许多其他成分会导致定位偏差并影响光刻机的定位精度。例如,实行器的推力颠簸、丈量噪声以及线圈和磁铁的加工偏差都会引起不愿定性和建模偏差。此外,不屈均的气隙厚度和电缆力会对长行程平台运动造成滋扰,这也在一定程度上与短行程平台耦合。这些建模偏差和滋扰将极大地影响超精密定位平台的定位精度。光刻机中的聚焦和调平过程对付提高晶圆上的曝光质量至关主要。因此,晶圆和掩模版平台的短行程和长行程都具有 6 自由度,以实现所需的聚焦和调平。然而,这些平台在每个轴之间具有交叉耦合运动学。因此,事情台的垂直调度对事情台的水平运动有显著的影响,从而引起定位精度的不愿定性,降落印刷集成电路的质量。
光刻机的偏差分类及预防技能
导致overlay和离焦偏差的低频定位偏差和导致图像褪色的高频定位偏差可分为平移、旋转、放大和梯形偏差,如1.3所示。这些定位偏差可以通过调度掩模板台位置来补偿
因此,由于掩模版和晶圆的定位精度对付生产高效的集成电路至关主要,并且由于掩模版和晶圆台之间的同步运动对付避免聚焦和重叠偏差至关主要,因此最小化 6-DoF 中两个台之间的相对定位偏差被视为光刻工艺的紧张性能哀求。
光刻机的动态架构旨在将所有非确定性动态滋扰与光学成像系统隔离。如图 1.1 所示,为了减少振动的影响,利用由实心混凝土制成的机器基座将晶圆扫描仪与由钢筋制成的地板连接起来。这样,基座将有效地将晶圆扫描仪安装在柔顺的地板构造上。此外,利用由钢制成的刚性底座来固定所有晶圆扫描仪组件。该底座直接安装在基座上,无需额外的隔振方法。此外,由于计量框架稳定地固定投影镜头,因此在基座和计量框架之间利用了三个空气支架,以减少这些框架之间的振动通报。此外,标线片和晶圆台由基座通过空气轴承或主动磁支撑支撑,以确保运动时污染更少、零滞后、零摩擦或磨损。此外,平衡质量漂浮在空气脚上,用于接管机器的反浸染力,该反浸染力约为几千牛顿。
对提高光刻工艺性能的贡献
许多研究有助于提高光刻工艺。中开拓了一种具有稳健性约束的迭代反馈调谐 (IFT) 方法;这样,在只须要非参数模型的情形下,就可以担保稳健稳定性。开拓的模型运用于光刻机的晶圆台,得到的结果证明了性能的提高和担保的稳健性估计。在 中,为高性能精密运动系统开拓了组合系统识别和稳健掌握设计框架,个中吞吐量和准确性是关键指标。将基于数据的多输入多输出 (MIMO) 前馈掌握设计运用于晶圆扫描仪的运动系统。
所提出的掌握设计能够处理未知的滋扰并将其对性能变量的影响降至最低。在中,为光刻机中的晶圆台开拓了基于数据的前馈掌握,以提高扫描性能,包括稳定行为和降落串扰效应。在中,提出了一种新颖的同步掌握构造,以提高同步性能并降落掩模版和晶圆台之间的同步偏差。
由于掩模版台中的磁悬浮系统导致其多个自由度之间产生耦合,中提出了一种自适应滑模掌握方法来改进跟踪偏差的收敛。通过补偿建模偏差和外部滋扰,所提出的掌握器有效地减少了(i)台内的耦合,(ii)扫描方向上的跟踪偏差,以及(iii)其他多个自由度中的定位偏差。
提出了一种光罩曲率操纵器,通过在光罩边缘的两个致动机构阵列中实现十四个压电致动器 (PZT),作为光刻机中的曲率校正技能。所提出的设计减少了由于镜头加热和晶圆不平整而导致的聚焦偏差。因此,估计聚焦偏差减少量约为 10 纳米。为了实现增强的扫描加速度,研究了一种新的光罩夹紧观点,个中肃清了光罩滑移,并减少了不可校正的光罩变形。所提出的光罩夹紧观点避免了通过摩擦通报加速度力,并利用支柱进入光罩以从运动学上限定它。通过利用压电堆栈致动器来肃清光罩滑移,这些致动器在光罩上施加受控的推力以抵消惯性负载。
-----END-----
免责声明:本文为作者独立不雅观点,不代表作者本人态度。如因作品内容、版权等存在问题或者其他任何异议,欢迎联系处理。
英文来源于 A Micro-Positioning Motion System to Enhance Lithography in Semiconductor Manufacturing Machines













