一、2D封装的散热路径与热设计
2D封装是一种传统的芯片封装办法,个中芯片的主热量方向是向上,即Top面/Case面。在2D封装中,散热路径相对大略明了。

散热路径:
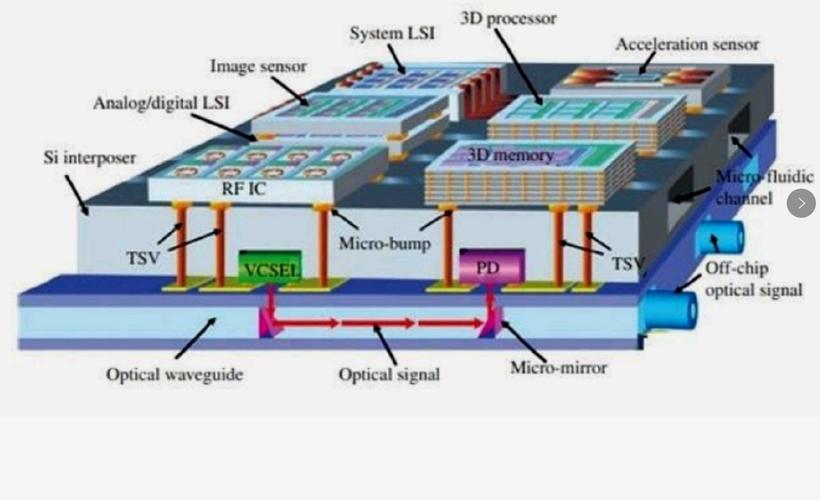
芯片产生的热量紧张通过封装内Die和封装外壳(Lid)之间的导热材料(TIM1)向上传导。
热量终极通过封装外壳散发到外部环境中。
热设计考虑:
降落界面热阻(RTIM):界面热阻是影响2D封装散热性能的关键成分之一。为了降落界面热阻,可以采取高性能的导热材料,并优化导热材料与芯片和封装外壳之间的打仗面积和打仗压力。
减少Lid产生的热阻:封装外壳(Lid)在散热过程中会产生一定的热阻。为了优化散热性能,可以考虑采取更轻、更薄且导热性能更好的材料来制作Lid,或者通过改进Lid的构造设计来减少热阻。
低功耗设计和布局优化:除了从散热路径上进行优化外,还可以通过低功耗设计和布局优化来降落芯片的发热量。例如,可以优化电路的功耗分布,只管即便使热量在芯片空间内均匀分布,从而降落局部热点温度。
二、3D封装的散热路径与热设计
比较于2D封装,3D封装通过将多个芯片堆叠在一起,实现了更高的集成度和更小的体积。然而,这也带来了更为繁芜的散热问题。
散热路径:
在3D封装中,芯片Die是堆叠的,因此热量须要通过多个Die进行传导。详细来说,第n个Die产生的热量将通过N-1个Die传导到位于芯片组中末了上面一个Die顶部的散热器或冷板。
热量终极通过散热器或冷板散发到外部环境中。
热设计考虑:
降落芯片自身的热阻(Rchip):由于3D封装中芯片是堆叠的,因此须要关注每个芯片自身的热阻。可以通过优化芯片的内部构造、材料和工艺来降落热阻。
降落界面热阻(RTIM):与2D封装类似,界面热阻也是影响3D封装散热性能的关键成分之一。除了采取高性能的导热材料和优化打仗面积及压力外,还可以考虑在芯片之间引入高导热系数的材料(如铜)来构建高导热通路。
减少Lid产生的热阻:如果3D封装中利用了Lid,同样须要考虑减少其产生的热阻。可以采取与2D封装类似的优化方法。
利用热电结合优化设计和基于TSV的多层堆叠芯片热设计:通过方案集成电路的功耗分布和优化布局来使热量在芯片空间内均匀分布;同时,利用三维集成电路中的高导热系数材料(如铜)构建高导热通路,实现热量在热点和热沉之间的高效传导。
考虑微流道冷却技能:这是一种前沿的散热方法,通过在硅衬底中刻蚀形成微流道来实现各层热量的层内散逸。这种方法可以大大缩短热量从热点到达热沉的间隔并降落散热热阻,但也须要考虑其设计繁芜度和可靠性问题。
三、总结
2D封装和3D封装在散热路径和热设计方面有着各自的特点和寻衅。2D封装的散热路径相对大略明了,紧张通过导热材料将热量向上传导至封装外壳;而3D封装则面临着更为繁芜的散热问题,须要通过多个堆叠的芯片进行热量传导。在热设计方面,两种封装都须要考虑降落界面热阻、减少Lid产生的热阻以及通过低功耗设计和布局优化来降落发热量;而针对3D封装的特点,还须要特殊关注降落芯片自身的热阻和利用高导热通路等方法来优化散热性能。随着半导体技能的不断发展,未来将有更多创新的散热技能和方法运用于2D封装和3D封装中,以知足不断增长的高性能打算需求。












