问题一:
BGA和CSP是通过锡球固定在线路板上,存在热应力、机器应力等应力集中征象,如果受到冲击、弯折等外力浸染,焊接部位随意马虎发生断裂。此外,如果上锡太多以至于锡爬到元件本体,可能导致引脚不能承受热应力和机器应力的影响。因此芯片耐机器冲击和热冲击性比较差,涌现产品易碎、质量不过关等问题。

办理方案:
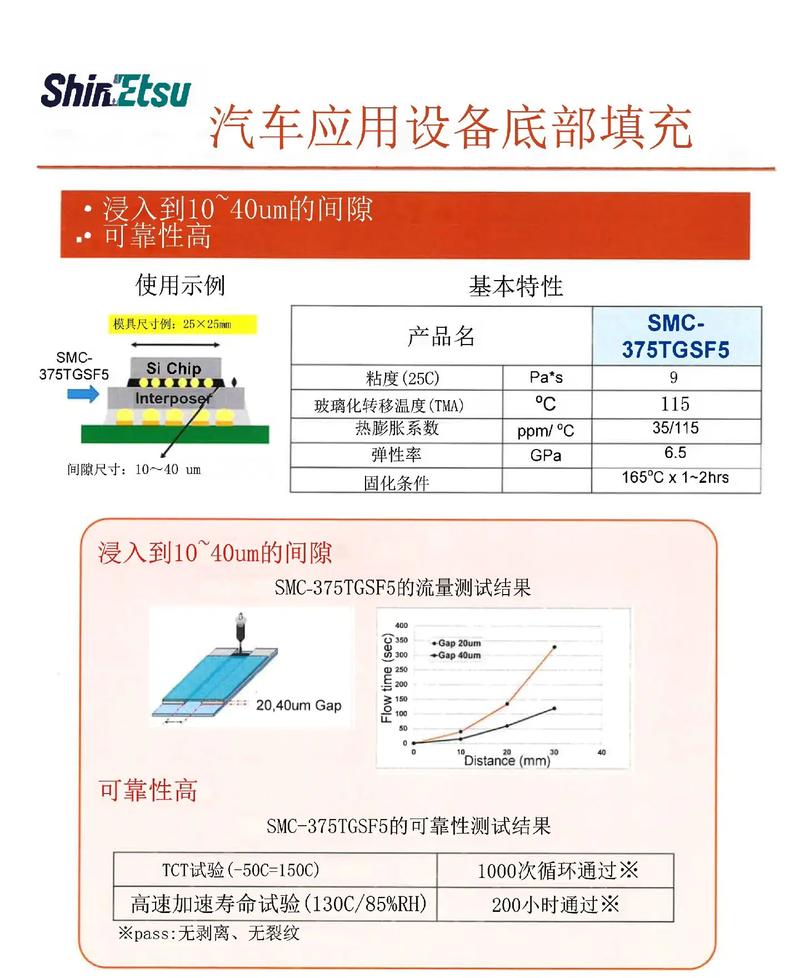
由于利用了底部添补胶的芯片在跌落测试和高低温测试中有精良的表现,以是在焊球直径小、细间距焊点的BGA、CSP芯片组装中,都要利用底部添补胶进行底部补强。汉思化学底部添补胶的运用,可以分散降落焊球上的应力,抗形变、耐波折,耐高低温-50~125℃,减少芯片与基材CTE(热膨胀系数)的差别,能有效降落由于硅芯片与基板之间的总体温度膨胀特性不匹配或外力造成的冲击。底部添补胶受热固化后,可提高芯片连接后的机器构造强度。
问题二:
客户在利用芯片胶底部添补胶的过程中,可能会涌现胶水渗透不进、固化韶光太长的问题。由于胶水流动性、基板污染等缘故原由,可能会造成胶水添补不饱满,从而对跌落测试造成影响,随意马虎产生开裂的问题。
办理方案:
汉思化学芯片胶底部添补胶,是一种单组份、改性环氧树脂胶,用于BGA、CSP和Flip chip底部添补制程,流动性好,快达3分钟完备固化,在毛细浸染下,对BGA封装模式的芯片进行底部添补,利用加热的固化形式,将BGA底部空隙大面积填满(添补饱满度达到95%以上),形成同等和无毛病的底部添补层,适宜高速喷胶、全自动化批量生产,帮助客户提高生产效率,大幅缩减本钱。
问题三:
助焊剂残留会挡住焊点的裂痕,导致产品失落效的缘故原由检讨不出来,这时要先洗濯残留的助焊剂。但是芯片焊接后,不能担保助焊剂被彻底打消。底部添补胶中的身分可能与助焊剂残留物反应,可能发生胶水延迟固化或不固化的情形。因此,在选择底部添补胶的时候要考虑助焊剂兼容性问题。
此外,由于线路板的代价较高,线路板组装完成后,对整板的测试过程,如果创造芯片不良,就要对芯片进行返修,这就哀求底部添补胶具有可返修性。
办理方案:
汉思化学芯片胶底部添补胶,采取前辈配方技能及原材料,具有高可靠性(防脱落、耐冲击、耐高温高湿和温度循环)、快速流动、工艺大略、平衡的可靠性和返修性、精良的助焊剂兼容性、毛细流动性、高可靠性边角补强粘合剂等特色优点,可以办理兼容性问题和返修问题,真正实现无残留,刮得净等。
问题四:
对付航空航天和军工产品,引脚脚跟处锡的上方水平线低于引脚脚尖处锡的上方水平线;引脚脚尖的下边未插入锡中;焊盘相对引脚的位置不对,引脚脚跟处没有上锡。上述缘故原由都可能会导致PCBA间歇性不良之失落效产品焊点正常。
办理方案:
底部添补胶紧张用于CSP、BGA 等倒装芯片的补强,提高电子产品的机器性能和可靠性。为了知足可靠性哀求,倒装芯片一样平常采取底部添补技能,对芯片和线路板之间的空隙进行底部添补补强。利用汉思化学底部添补胶,可以增强BGA封装模式芯片和PCBA间的抗跌落性能,提高产品的可靠性。
欢迎广大有需求的客户与汉思新材料互助,我们将竭诚为您做事。














