QFN是方形扁平无引脚封装的简称。这种封装底部中心有一个大面积袒露焊盘,用于导热和连接外围的封装。四周有实现电气连接的导电焊盘。由于QFN封装不像SOIC和TSOP那样有鸥翼状引线,因此它具有较短的导电路径和较低的自感系数,封装体内的布线电阻也较低,因此它能供应卓越的电性能。此外,它还通过外露的引线框架焊盘供应出色的散热性能。这种焊盘具有直接散热通道,用于开释封装内的热量。常日将散热焊盘直接焊接在电路板上,并且PCB中的散热过孔有助于将多余的功耗扩散到铜接地板中,从而接管多余的热量。
如何封装QFN器件?

·磨片是晶圆厂将圆片减薄的一道工序,以便于在有限的空间内进行封装。从晶圆厂出来的圆片一样平常厚度为550~725um,而常规QFN封装总厚度也为550到750微米。因此,如果不经由减薄处理,芯片将无法进行封装。
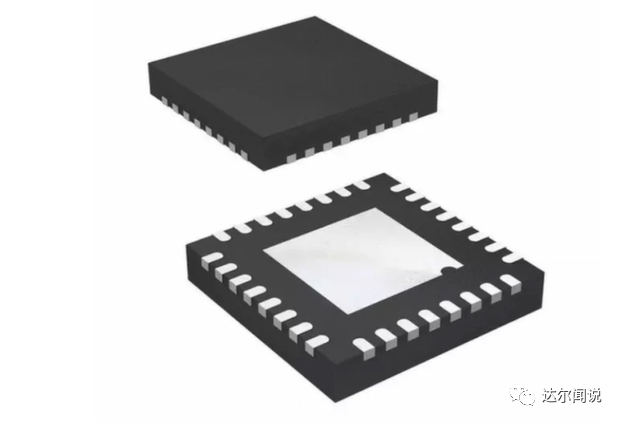
·目前主流的磨片设备来自日本的DISCO,而划片则是将圆片上的独立芯片进行切割分离的一道工序。将一片圆片上成千上万个独立功能的芯片进行切割分离,方便后面的封装。芯片的制造工艺和划片槽的构造设计决定了划片办法的选择(普通刀切或分外镭射)。
·主流的划片设备有来自日本的DISCO和精工。装片将分离好的芯片从已划开的圆片上取出并放到金属载体框架上,芯片与金属载体通过银浆或粘结膜进行连接。
·装片的主流设备有来悛改加坡的ASM和瑞士的ESE。焊线利用自动焊线设备将芯片的功能Pad与框架的管脚用焊线(金银或铜线)连接起来,将芯片设计的功能通过框架管脚连接到表面的电路板上,确保产品通电后可以正常事情。
·焊线的主流设备来自美国设备产商K&S和新加坡ASM。包封利用自动注塑设备将已焊线好的芯片和金属载体用环氧树脂(常日为玄色)通过高温压力注塑的办法覆盖包裹并固化,在芯片外部形成物理保护。
·如果金属载体即框架背面为铜材,为了防止裸铜氧化并确保封装好的芯片,可以用SMT办法与电路板成功焊接,须要在铜材上镀上一层锡。设备可以选用海内的新阳新基。为了方便对芯片进行追溯,一样平常会利用激光打印设备在玄色环氧树脂表面将产品名称、客户标识乃至批次信息等打印在单颗产品上。常见的QFN设备有台湾的钛升和海内的新基,在切割前,须要将一定数量的芯片放置在条状框架载体上,末了采取机器切割的办法将芯片分割开。常见的QFN设备有日本的DISCO和韩国的HANMI。
以上是QFN流程的参考流程,详细流程会根据工厂实际情形、产品作业状况和产品设计特点等成分略有不同,但整体事理相似。一样平常来说,QFN常用的考察项目包括预处理(Pre-con)、高温存储试验(HTSL:high temperature storage life)、温度循环试验(TCT:temperature cycletest)、高压蒸煮试验(PCT:pressure cycletest,加速温湿度试验(UHAST)、ECCENTRIC CONTRACTION,或当肌肉变永劫进行的盆子压力测试)、肌肉拉伸试验(PCT:pressure cycletest)等。
举个例子:和易焊性试验(ST:Solderbility test),详细封装形式对应的可靠性条件哀求,可以参考联合电子设备工程委员会(JEDEC)干系文件。目前采取QFN封装形式的芯片运用非常广泛,如蓝牙芯片、音频芯片、电源管理芯片、功率放大芯片、基站时钟芯片、视频监控芯片等。
QFN封装是一种适用性强、构造大略、性价比高的封装形式,在可预见的5年内涌现替代封装的可能性不大。就像产品在职场中一样,如何才能不被取代也是我们须要思考的问题。
本日的分享到此结束,欢迎大家关注半导体封装工程师之家。













