划片系统进行划片(切割)的,现在这种方法仍旧霸占了天下芯片切割市场的较大份额,特殊是在非集成电路晶圆划片领域。金刚石锯片(砂轮)划片方法是目前常见的晶圆划片方法;
刀片切割存在的问题有:

1.机器划片是机器力直接浸染在晶圆表面,在晶体内部产生应力损伤,随意马虎产生晶圆崩边及晶片破损;
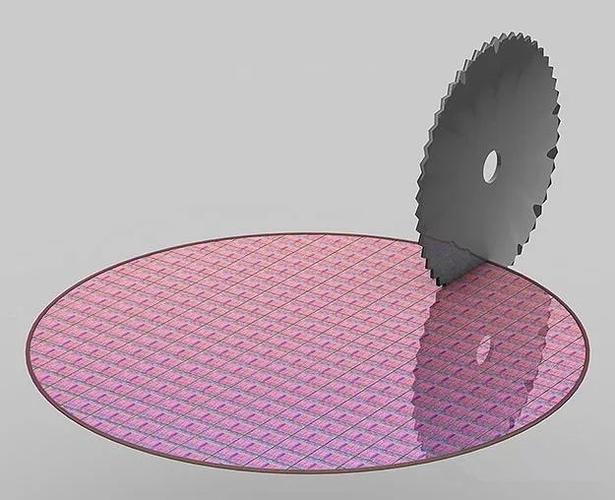
2.由于刀片具有一定的厚度,由此刀具的划片线宽较大。金刚石锯片划片能够达到的最小切割线宽度一样平常在25~35微米之间;
3.刀具划片采取的是机器力的浸染办法,因而刀具划片具有定的局限性。对付厚度在100做米以下的晶圆,用刀具进行划片极易导致晶圆破碎;
4.刀片划片速率为40-80mm/s,划片速率较慢。且切割不同的晶圆片,须要改换不同的刀具;
5.旋转砂轮式划片( Dicing Saw)须要刀片冷却水和切割水,均为去离子水(DI纯水);
6.刀片切割刀片须要频繁的改换,后期运行本钱较高。
激光切割属于无打仗式加工,不对晶圆产生机器应力的浸染,对晶圆损伤较小由于激光在聚焦上的优点,聚焦点可小到亚微米数量级,从而对晶圆的微处理更具优胜性,可以进行小部件的加工;
激光切割存在的问题有:
1.激光划片是非机器式的,属于非打仗式加工,可以避免涌现芯片正面破碎和其它破坏征象,激光划片后须要利用传统工艺将芯片彻底划开。
2.激光划片采取的高光東质量的光纤激光器对芯片的电性影响较小,可以供应更高的划片成品率牡丹石激光器未花费材料,本钱较高。











