老化在技能界得到了很好的研究,那么朽迈背后的物理机制究竟是什么?

“老化实质上是我们通过晶体管通道驱动电子的速率,”西门子 EDA的 AMS 产品管理卖力人 Sathish Balasubramanian 说。
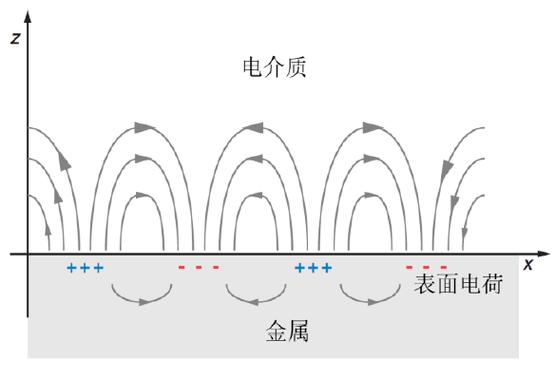
这反过来又会带来一些权衡。“从设计的角度来看,险些每个设计师都对老化方面的不同事物感兴趣,”自适应系统部 Fraunhofer IIS Engineering 的质量和可靠性小组经理André Lange 说。
也便是说,它的形象已经上升为一个关键的验证目标。“我们一贯专注于 PPA,”Balasubramanian 说。“该当是 PPA 2 ”,考虑到四个关键成分——性能、功率、面积和老化。
只有少数已知会缩短芯片寿命的效应,个中许多都涉及电荷被困在不属于它们的地方。有些可以通过技能改进来缓解,而有些则须要仔细设计和验证。老化仿照已被证明对设计师有很大帮助,但没有快速简便的办理方案。终极,随着系统老化,片内监控有助于密切关注现场系统。
为什么我们现在担心老化
电路老化一贯存在。然而,在过去,硅和其他材料可以做的事情有更多的余地和更少的限定。“老化效应和降解机制在理论上一贯存在,”proteanTecs 产品营销高等总监 Marc Hutner 说。“我们开始看到的是它们在高性能运用程序中的广泛表现,例如数据中央。大型超大规模企业正在报告他们不习气看到的打算故障和随机毛病。我们估量,随着设计的缩小、技能节点的进步以及性能和可靠性哀求的激增,这一趋势将会增加。”
过去,由于老化导致的设备故障可能会在芯片的预期寿命之后良久才涌现——如果有的话。然而,随着节点越来越激进,材料的推动力越来越大,出错的空间也越来越小。老化可能发生得更快,如果处理不当,设备的预期寿命乃至比其预期系统的寿命更短。
虽然半导体老化会影响任何运用,但一个市场比其他任何市场都更关注它。“汽车是在设计中考虑设备老化的紧张驱动力,”Fraunhofer 的 Lange 说。
这是由于两个成分——汽车的利用寿命必须比普通智好手机长得多,而且故障可能会产生安全后果。因此,原始设备制造商和一级供应商不得不仔细研究老化效应以及如何保护系统免受老化影响。
但除了汽车之外,任何必须持续很永劫光的芯片都会受到影响。Balasubramanian说:“我们正在考试测验进行城市方案,例如污水掌握系统、工业物联网中的关键任务或边缘系统,在这些系统中,给定芯片的每个终极运用都决定了如何加固它们以防老化。”
虽然有许多关于如何减轻朽迈影响的信息来源,但对朽迈根源的挖掘却很少。目前尚不清楚具有电子穿过它们的稳定材料会以何种办法磨损。事实证明,导致朽迈的影响相对较少,并且大多数与移动电子碰着物体时所通报的能量有关。
金属迁移
第一个已知影响是一个古老的影响,可以追溯到几十年前。这里的问题是,当电子在导体中碰撞时,它们实际上可以推动金属离子。效果是渐进的,但随着韶光的推移,导体中会涌现间隙。纵然没有完备断开连接,它的电阻也会随着它变窄而增加。
这种效应是由电流密度驱动的。随着空隙的形成,这会产生正反馈效应。电流密度与流过导体横截面的电流量有关。如果该导体因电迁移而变窄,则可用横截面会减少,从而增加电流密度并使问题恶化。
缓解涉及管理电流密度。可以通过增加金属横截面(通过加宽金属,由于高度是固定的)或降落电流来减少它。长期以来,仿真工具使运行检讨成为可能,以确保电流密度在全体设计中保持在界线内。
还有另一种形式的金属迁移可能会或可能不会成为问题。金属-介电界面可能是物理应力的来源,这会导致金属移动。这是双镶嵌铜工艺早期的一个问题,金属壁上的应力。
这常日被认为是一个固定的问题,但尚不清楚它是否会在最具攻击性的节点上再次举头。
被俘获电荷的影响
导体和绝缘体的观点大略地假设电荷载流子仅在导体中移动并且绝缘体是电惰性的。虽然这可能是真的,但普遍存在的被困电荷问题违反了这一原则。
俘获电荷是一种以某种办法嵌入绝缘体中的电荷。它可能会四处移动,但最有可能留在原地。由于这些电荷不是流动的,它们不会直接参与任何电流流动,但它们会导致泄露并终极导致击穿。
在大多数情形下,电荷俘获是一种不受欢迎的征象。虽然一些运用程序(如闪存)可以利用电荷捕获作为存储机制,但在其他方面无济于事。
陷阱可以被认为是吸引和保持电子的毛病。这是栅极电介质中最受关注的问题,个中捕获的电荷会影响阈值电压。它们还使通道中的载流子更随意马虎穿过门。
有在制造过程中产生的内在陷阱,也有在操作过程中产生的外在陷阱。由于后者,捕获的电荷会随着韶光的推移而积累,这确实是导致大多数老化的缘故原由。
本征陷阱可能由不完美的电介质形成以及电介质与硅之间的界面引起。在电介质中,电荷可以被捕获在绝缘体晶格中存在毛病的任何地方。
虽然有可能成长出极高质量的氧化物,但它所花费的韶光可能会使这种工艺变得不经济。“当你有良好的栅极氧化物时,你内部不会有太多的陷阱,”朗格说。“只管如此,拥有这些良好的栅极氧化物须要付出更多的努力。”
由于涉及的温度和韶光,退火可能不实用,详细取决于过程中的位置。“是否可以进行高温工艺步骤总是取决于之前的工艺步骤,”朗格指出。“一些高 K 电介质并不真正喜好高温。”
现实仍旧是电介质中总会存在一些毛病。
界面处的陷阱
在硅界面处,会有开放的或“悬空的”硅键。这些用氢钝化。但并不是每一个悬空的债券都可能被填满,剩下的那些将是陷阱。
此外,通道中的空洞可能会诱使氢气阔别其位置,从而打开陷阱。“这紧张是由于位于氧化硅界面的硅/氢键断裂,”西门子 EDA 仿照和稠浊旗子暗记产品工程总监 Ahmed Ramadan 说。
一样平常来说,疏水阀将取决于用于防止泄露的材料和任何添加剂。从二氧化硅到氧化铪(或其他高K 电介质)的转换并没有肃清本征陷阱。
除非电子进入个中,否则这些毛病不会引起问题。即便如此,单个被捕获的电子也不太可能被把稳到。老化效应与这样一个事实有关,即一旦被捕获,电子可能难以分开,这可能是一种累积效应。
以下是具有不同名称的电荷捕获的详细缘故原由和影响,详细取决于它们的影响。虽然它们占主流运用程序老化的大部分缘故原由,但某些运用程序——尤其是那些必须经受住严厉太空磨练的运用程序——可能还有其他贡献。
“例如,由于 α 粒子,你会碰着单事宜扰动,”Lange 指出。“由于高能离子也会导致永久性降解,因此总电离剂量也是一个问题。”
热载流子注入
电流中的载流子会有能量分布,个中一些会比其他的更有活力——或者说“热”。这些载流子可以使电子穿过相邻的绝缘体,将自己嵌入(乃至产生)陷阱中。这称为热载流子注入 (HCI)。
“热载流子注入是由于漏极侧发生的高电场,”Ramadan 说。“这种高电场实际上会推动得到足够能量的电子与硅晶格原子碰撞并产生电子/空穴对。孔常日会到达 NMOS 器件的衬底。电子将被推向硅/二氧化硅界面。它们将与其他硅原子碰撞,产生更多的电子/空穴对,这种效应称为“碰撞电离”。这些电子既可以驻留在二氧化硅界面内,也可以通报到栅极。”
当漏极电压相对付栅极较高时,这每每会成为更大的问题。“听说当漏极电压是栅极电压的两倍时,这是一个问题,”Ramadan 指出。
图 1:高能载流子撞击硅原子,产生电子/空穴对,电子被困在附近的电介质中。
新电子可能会在此过程中产生其他电子对,孔将向基板移动。
资料来源:Bryon Moyer/Semiconductor Engineering
这种机制被明确地用于闪存编程的一方面。除此之外,这是一种不受欢迎的征象。
负偏压和正偏压温度不稳定性
这是一种可以逐渐降落晶体管阈值电压的效应。负偏压温度不稳定性(NBTI) 会影响 PMOS 晶体管,并且随着韶光的推移越来越受到关注。正极版本 (PBTI) 会影响 NMOS 晶体管,并且它也被考虑用于激进节点。两者都在较高温度下加剧。
对付 NBTI,捕获载波的陷阱可能有两个缘故原由。一种是栅极电介质内存在大略的本征陷阱。这也是 PBTI 背后的紧张机制。
NBTI 的另一个俘获电子来源是通道/氧化物界面。与涉及热电子的 HCI 不同,这些征象会导致电子在电场的影响下缓慢漂移进入并通过栅极电介质。请把稳,这方面不被认为是影响 PBTI 的机制。
这些电子改变了晶体管的阈值。“阈值电压会低落,这会影响电路的整体延迟,这将变得更糟,”Ramadan说。
图 2:从硅漂移到电介质中的载流子(蓝色圆圈)。玄色圆圈是陷阱,个中一些被盘踞。
如果去除氧化物两端的电压,体陷阱捕获的电荷会随着韶光逐渐开释。“如果制造过程中存在预先存在的陷阱,它们将被孔洞填满,”Ramadan 说。“当你肃清[电压]压力时,它就会消逝。”
从理论上讲,PBTI 和部分 NBTI可能是可逆的——这使得它们不是真正的老化问题。
但是解除电荷俘获的弛豫韶光可以从毫秒到几小时不等。就事情集成电路的韶光尺度而言,这些韶光尺度很长。这意味着,纵然这种效应在技能上是可逆的,但在某些电路中可能没有机会这样做。在这种情形下,它还可以有效地起到老化机制的浸染。
目前尚不清楚界面陷阱是否会开释它们的电荷。“与对应于硅/氢键的空穴碰撞产生的陷阱。去除氢键会留下一个悬空的硅键,”Ramadan 说。“这些都没有规复。”
或者换句话说,纵然肃清了压力,氢气也不会返回现场。
“NBTI/PBTI] 和 HCI 对电路设计职员来说很主要,由于它们都会导致晶体管性能的逐渐转变,从而导致电路性能的逐渐转变,”Lange 说。
增加泄露
电子穿过电介质的另一种机制是隧道效应,而 Fowler-Nordheim 隧道效应是一种非常分外的机制,通过该机制,电介质上的电压会缩小隧道势垒。电压越高或氧化物越薄,电子越随意马虎通过隧道。
图 3:解释 Fowler-Nordheim 隧穿的简化能带图。在左侧,没有施加电压,势垒太宽而无法穿过。在右侧,在施加电压的情形下,较薄的部分可以实现隧道效应。
这种效应被故意用于原始的电可擦除可编程 ROM (E 2 PROM),并且仍旧用于利用浮动栅极的位单元的闪存编程机制的一侧(另一侧利用 HCI)。但是,只要有电压穿过薄势垒,就会发生隧穿,无论是否须要。
这些电子可能会被沿途的毛病捕获,这意味着它们可能无法穿过电介质。但它们确实降落了进一步隧穿的势垒,这可能导致通过电介质的泄电流增加。
与韶光干系的电介质击穿
随着更多被俘获的电子在电介质中积累,其整体击穿电压会低落。虽然电荷缓慢积累,但在某些时候会形成“渗透路径”,从而使电介质失落效。这会导致“韶光干系的介电击穿”或 TDDB。
与范例的老化机制不同,这意味着会涌现溘然故障,而不是性能逐渐降落导致故障。虽然已经对这种效果进行了建模,但对付某些设计来说,这些模型可能过于守旧。
“我们有从事 RF 事情的互助伙伴见告我们,静态 TDDB 模型会预测电路在开启后会立即涌现故障,”Lange 说。“实验表明情形并非如此。问题是您的高压尖峰非常快,以至于它们不会导致您期望从该高度的直流应力中产生的破坏。”
模型没有很好地捕捉到这一点,因此如果当今射频设计受到过度约束,则须要做更多的事情。
温度循环疲倦
前辈封装带来了其自身的寻衅,与可能封装在个中的单个裸片无关。“在谈论退化和老化源时,我们须要考虑的另一个成分是前辈的异质封装,”Hutner 说。“这意味着我们实际上正在扩展‘老化’这个术语,以包括新征象。”
对付繁芜的多芯片封装,有多种材料具有不同的热膨胀系数 (CTE)。这意味着随着温度的变革,材料将以不同的速率膨胀和紧缩。随着韶光的推移,这些差异可能会导致金属连接失落效时的不连续性。
如果设计中没有充分办理这种长期温度循环问题,那么带有机器元件的设备(如 MEMS 芯片)也可能涌现内部故障。这样的故障将导致精度低落或设备彻底去世亡。
设计前剖析和设计后监控
虽然理解底层机制有助于减轻芯片的老化效应,但应通过剖析工具抽象出细节。这些工具的质量将取决于它们利用的模型的质量。
“如果设计职员想将他们的设计推向极限,他们须要确保他们拥有能够捕捉这些可靠性影响的良好模型,”Ramadan 指出。“大多数代工厂实际上都热衷于在他们的模型中加入 NBTI 和热载流子注入。我们还看到了专门用于汽车运用的 TDDB 模型。”
但验证老化并不像按下按钮那么大略。“这些仿照取决于您利用的任务配置文件,”Lange 警告说。“电路的用场是什么?什么是关键或范例的利用条件?另一个问题是,利用哪些模型来仿照器件退化或电路性能的影响?这些模型必须支持仿真中的其他瞬态波形。他们必须准确评估您感兴趣的 IV 曲线中的所有点。”
随着对朽迈的理解越来越多,该当更新这些模型,从而更随意马虎环绕朽迈进行设计——纵然每一代人的影响都会变得更糟。
“对物理上发生的事情的基本理解已经相称不错了,纵然对付非常非常小的节点也是如此,”Lange说。“但要使这些模型可用于不同的技能或不同的晶体管类型,还有很多事情要做。”
硅前验证虽然很关键,但还不足。老化是监控电路被包含在高等 IC 中的紧张缘故原由之一。“SoC 须要变得智能,嵌入智能监控办理方案,以供应有关其康健状况和性能低落预测的实时反馈,”Hutner 说。
可以不雅观察关键参数,剖析指向可能因老化而涌现故障的设备。在适当的情形下,这些芯片——或者它们被焊接到的电路板——可以在它们的故障导致更大的问题之前被改换。
那么,老化效应彷佛会持续存在。但是,在减缓老化的设计验证和不雅观察老化过程的实时监控之间,系统可以得到更好的保护,由于它们越来越多地渗透到我们的生活中。
来源:北京半导体行业协会
半导体工程师
半导体履历分享,半导体成果互换,半导体信息发布。半导体行业动态,半导体从业者职业方案,芯片工程师发展进程。














